第九届华进开放日圆满落幕
2022年9月16日,集成电路先进封装产业链协同创新发展论坛暨第九届华进开放日在无锡新湖铂尔曼酒店成功举办。华进开放日活动旨在为业界同仁提供了一个分享行业观点和开拓市场机遇的专业平台,本次开放日由华进半导体封装先导技术研发中心有限公司主办。

随着数字经济的快速兴起,未来我们将面对的是大规模结构性增长的计算需求,YOLE预计2024 年 HPC 市场规模增至 470.14 亿美元,2020 年至 2024 年 HPC 市场规模年均复合增长率达 10.7%。在如此庞大的市场需求下,必将极大得带动整个IP生态系统使用并优化先进的技术。
今年会议交流主题聚焦高性能计算封装工艺等相关热门议题,包括Chiplet、Hybrid bonding、近存计算高密度封装等,由华进公司资深副总经理秦舒和工程部部长张春艳主持,华进公司总经理孙鹏致欢迎词。


华进开放日由华进公司总经理孙鹏博士、中科院计算所互连技术实验室主任郝沁汾博士、国防科技大学计算机学院副研究员罗章博士、南京大学田静博士、中科院微电子所系统封装与集成研发中心主任王启东博士、长电科技技术总监萧永宽、Prismark执行合伙人Shiuh-Kao Chiang、芯和半导体资深技术总监苏周详、复旦大学微电子学院教授陶俊博士、浙江大学微纳电子学院副教授朱晓雷博士、盛美半导体资深工艺总监贾照伟以及北方华创封装及功率器件行业发展部总经理吴文英十二位重量级嘉宾与会报告,呈现了一场半导体先进封装的技术盛宴。

作为首个报告嘉宾,华进公司总经理孙鹏博士介绍了在芯片互连节距持续减小的情况下,混合键合技术的市场需求和技术优势,国内外各大头部企业的技术现状和产品应用情况,以及华进公司晶圆级混合键合技术的研究进展。
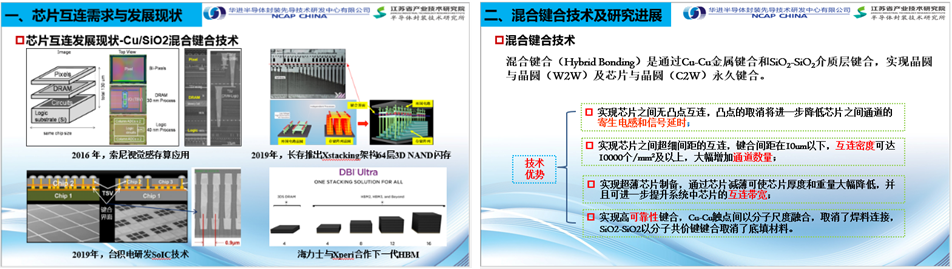
(华进半导体报告)
中科院计算所互连技术实验室主任郝沁汾博士介绍了针对多种应用场景的芯片设计,分析chip-let、晶圆级计算系统等新型芯片设计发展技术路线和技术趋势,梳理后摩尔时代不同新技术对先进封装技术的强烈需求,提出针对我国先进封装工业投资和技术研发的一些建议。
国防科技大学计算机学院副研究员罗章博士从光电集成互联的角度,为我们深入浅出的解读了光电集成互联的现状需求以及Chiplet架构下光电集成发展方向,他认为高端芯片的Chiplet化为光引擎纳入集成芯片设计准备了良好的平台。

(国防科大罗章博士)
南京大学电子科学与工程学院副研究员田静博士分享了后量子密码算法的优化与高性能实现,介绍了格、散列、同源PQC等加密算法的优化与实现。

(南大田静博士)
中科院微电子所系统封装与集成研发中心主任王启东博士结合目前集成电路行业发展对Chiplet芯粒集成技术的需求,探讨先进封装技术目前的发展状态、关键技术难点与下一阶段的发展路线,并对芯粒集成技术在中国的发展做了进一步展望。
长电科技技术总监萧永宽为我们分享了小芯片封装,由于性能、成本和上市时间需求,较小的 Chiplets(即异构集成)将成为未来发展趋势。目前通过提供各种类型的小芯片封装来丰富小芯片封装多样性,例如FC SiP或PoP,高密度扇出型封装,2.5D,3D等。

(长电科技萧永宽)
北方华创封装及功率器件行业发展部总经理吴文英为我们解读了在2.5D/3D TSV通孔的开口尺寸不断缩小,向亚微米方向发展,同时深宽比不断提高,给TSV通孔刻蚀,liner沉积,Barrier seed 沉积等挑战下,半导体设备将如何实现高均匀性高良率的通孔制作。

(北方华创吴文英)
作为知名的咨询公司,Prismark执行合伙人Shiuh-Kao Chiang博士从多芯片堆叠和chiplet的发展、混合键合、高密度内存封装、硅光以及先进封装基板方面给我们带来了全方位细致的解读。

(Prismark报告)
在芯片粒之外,另一个值得我们关注的动向是芯片和软件协同设计,芯和半导体资深技术总监苏周祥为我们精彩演绎了Chiplet技术的特色、在设计中面临的挑战以及解决之道。

(芯和半导体苏周祥)
复旦大学微电子学院教授陶俊博士分享了大规模集成电路超低失效率分析,介绍了针对高维空间的SSS、SUS方法,以及用于估计系统失效率的APA、APE方法等。浙江大学微纳电子学院副教授朱晓雷博士为大家直播分享了神经形态计算芯片大规模扩展技术,他认为要实现超大规模神经形态计算硬件系统,亟需融合大脑神经科学、集成电路与芯粒(Chiplets)先进封装的先进成果,研究新型的大规模可扩展的并行信息处理架构并且发展基于先进EDA工具的芯粒集成系统协同设计方法学等。盛美半导体资深工艺总监贾照伟聚焦三维堆叠中的电镀工艺,较薄且均匀的覆盖铜层将提高ECP和后续CMP的产能,从而实现较低的工艺成本。

(复旦大学陶俊博士) (盛美半导体贾照伟)
作为国 家级封测/系统集成先导技术研发中心,华进公司肩负着促进国内外产学研合作,推动中国集成电路产业做强做大的使命。华进公司从2013年开始举办先进封装及系统集成研讨会,希望能集同行之力共同推动中国集成电路封测产业的发展。本次开放日活动虽然受到疫情及台风等不可抗力的影响,但仍然吸引包括OSAT、OEM、终端用户、设备及材料供应商等在内的近百家半导体企业参会,相信未来将有更多的半导体追梦人在此相遇相知,带着共同的信念为集成电路事业做出巨大贡献。我们明年再见!


 中文
中文
 English
English 苏公网安备 32021402001899号
苏公网安备 32021402001899号