服务范围
1. 设计仿真服务:
电学仿真、热管理和热机械可靠性仿真、工艺仿真等。
2. 先进封装设计加工服务:
8/12英寸晶圆级封装工艺服务:Bumping、WLCSP、FOWLP、TSV、2.5D/3D。
SiP封装、先进传感器封装、高速高密度封装、高速高频器件封装、特种CIS封装、三维封装
基板生产:FCCSP 以及FCBGA 相对应的基板封装服务,包含高密度基板、coreless基板、玻璃基板
3. 测试服务及可靠性失效分析服务:
3.1 电学测试:拥有先进的电学测试设备,可进行信号完整性、电源完整性、模拟、数字、RF、材料电学参数(损耗角、介电常数等)、EMI等电学性能的测试。
3.2 可靠性测试及失效分析:拥有热冲击/循环实验箱、高速老化箱、DMA、TMA、TGA以及X-ray等先进的失效分析设备,主用于对基板、封装进行温、湿度循环实验以及对失效封装进行分析。
3.3 热测试平台:拥有微型压缩机、压力传感器、热电偶、冷凝剂、NI控制器、真空泵等热测试设备
4. 工艺结构验证服务:
华进可以提供如下规格的标准假片;如有其它需求,亦可定制。
| RDL | TSV | Bumping | Oxide Wafer | Cu Wafer |
RDL
规格书:
Item | Single Side RDL | Double Side RDL |
Min Si Thickness | 60um | 60um |
Copper Thickness | >6um | >6um |
Copper Line/Space | Min 10um/10um | Min 10um/10um |
Chip Size | Target ±20um | Target ±20um |
Min Chip Size | 0.6mm×0.3mm | 0.6mm×0.3mm |
Tape&Reel | Min die thickness 90um | Min die thickness 90um |
结构示意图:
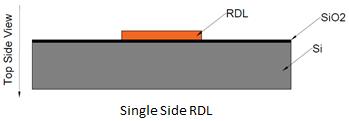
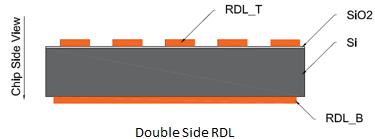
TSV
规格书:
Item | TSV 10:100 | TSV 20:200 |
Wafer size | 300mm | 300mm |
Si Thickness | 100um±10um | 200um±10um |
Via size | 10um±1.5um | 20um±3um |
Metal layers | Top side:3 | Top side:3 |
Copper Line/Space | Min 10um/10um | Min 10um/10um |
Micro Bump Pitch | Min 40um | Min 40um |
结构示意图:
![]()
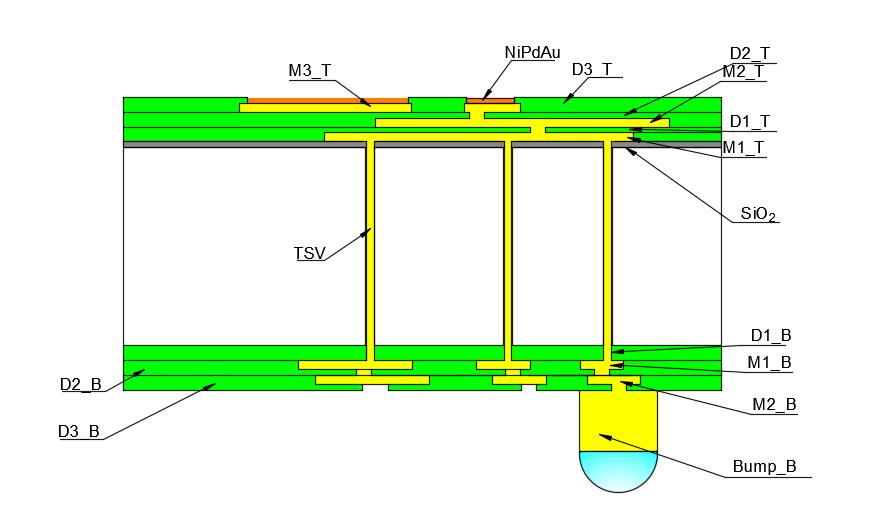
Bumping
规格书:
Item | Wafer Bumping |
Wafer Size | 300mm/200mm |
Bump Pitch | Min 80um |
Bump Size | Min 50um |
Bump Height | <80um |
RDL Line/Space | Min 10um/10um |
结构示意图:
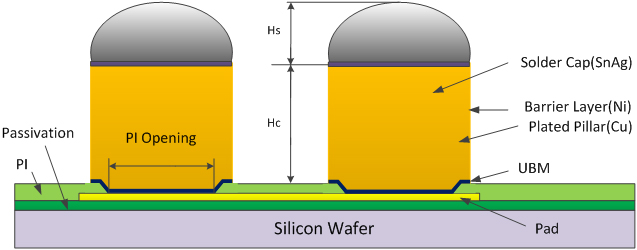
Oxide Wafer
规格书:
Item | Oxide Wafer | Oxide Wafer |
Wafer size | 300mm | 200mm |
SiO2 Thickness | 0.1um~6um | 0.1um~6um |
Cu Wafer
规格书:
Item | Cu Wafer | Cu Wafer |
Wafer size | 300mm | 200mm |
Cu Thickness | ≥1um | ≥1um |
5. 战略调研与知识产权服务:
国际知名调研机构Yole Development公司中国区制定合作伙伴和代理,可提供先进封装相关领域标准或定制调研报告。
依托公司知识产权服务平台与专业技术团队,可提供先进封装相关领域知识产权调研、分析等服务。


 中文
中文
 English
English 苏公网安备 32021402001899号
苏公网安备 32021402001899号