扇出封装工艺对比(2020年版)
早在2015年,只有OSAT参与扇出封装。2016年,台积电推出inFO封装技术,引领晶圆代工厂进入该市场。紧接着,像三星这样的IDM也加入了竞争,推出了自有的板级技术。最终,到2019年,OSAT的市场份额仅有三分之一。尽管市场份额有所下降,但他们仍在开发和加强这一领域的技术组合。

近年来,日月光联合Deca开发了M系列技术,进入扇出核心市场。随后,纳沛斯从Deca购买了这项技术。随着市场的不断发展,System Plus总结了市场现有技术现状,分析了OEM扇出封装的技术和成本选择。
针对不同应用领域的扇出封装,本报告提供了技术数据方面的见解。报告包括采用不同扇出封装方案的八大元件对比分析,从电源管理集成电路(PMIC)、处理器、雷达单片微波集成电路(MMIC)。

报告从工艺流程、成本和集成度等多方面,对元件的物理数据进行了比较,如:
英飞凌、安靠、星科金朋的eWLB技术
纳沛斯的RCP技术
日月光和Deca的M系列技术
台积电的inFO技术
三星电机的ePLP技术
报告介绍了市场五大扇出技术的工艺流程,以及完整的封装成本分析,分析了OEM的选择。
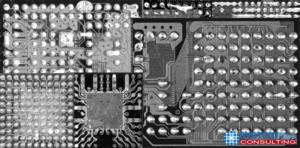


关于《扇出封装工艺对比(2020年版)》
报告提供了详实的照片及截面图、精确的测量数据(L/S、材料、尺寸)、制造工艺流程以及供应链评估;并对制造成本就行分析和比较。

报告目录
相关报告
《日月光/Deca M系列扇出工艺》
《苹果手表S4系统级封装中的先进封装技术》
《三星 Exynos9110中的ePLP工艺:三星初代FO-PLP》
《扇出封装:技术和市场趋势(2019年版)》
《扇出封装设备与材料(2019年版)》
《先进封装市场趋势(2019年版)》
购买方式
如需样刊或购买报告,请联系华进战略部:0510-66679351 Xiaoyunzhang@ncap-cn.com
以上图文译自Fan-Out Packaging Processes Comparison 2020
原文请参考:https://www.i-micronews.com/products/fan-out-packaging-processes-comparison-2020/

关于华进
华进半导体于2012年9月在无锡新区正式注册成立,开展系统级封装/集成先导技术研究,研发2.5D/3D TSV互连及集成关键技术(包括TSV制造、凸点制造、TSV背露、芯片堆叠等),为产业界提供系统解决方案;同时开展多种晶圆级高密度封装工艺与SiP产品应用的研发,以及与封装技术相关的材料和设备的验证与研发。
微信:NCAP-CN



 中文
中文
 English
English 苏公网安备 32021402001899号
苏公网安备 32021402001899号