系统级封装技术及市场趋势(2020年版)
供应链管理是系统级封装业务成败的关键因素
近年来,随着系统级封装从低端应用(小尺寸、I/O数少)拓展至高端应用(大尺寸、I/O数多),其市场需求量显著增加。
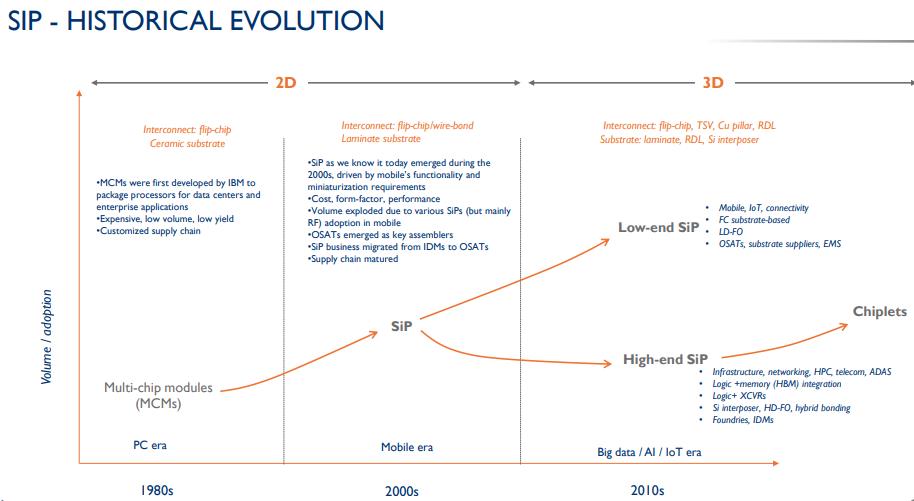
系统级封装历史演变
目前,制造商采用的商业模式是SiP成功与否的关键因素。也就是说,相对材料、技术、成本等典型的关键因素,商业模式对SiP的成功更为关键。SiP利用现有技术和基础设施实现多颗芯片的封装。但是,如果出现交付或者质量问题导致其中一颗芯片无法到位,整个SiP生产过程将被迫中断。因此,SiP解决方案还需要组装和测试能力。因此,对无晶圆厂和设计公司而言,能够提供完整SiP服务的业务模式才是最佳制造选择。
不幸的是,在目前的供应链环境中,现有的业务模式(晶圆代工厂、OSAT、基板制造商等)几乎不可能建立一个完整的整体解决方案,必须转换业务模式以获得所需的功能。在SiP产业背景下,将涌现新的业务模式趋势。Yole相信OSAT和晶圆代工厂都有潜力逐步提供整体解决方案。例如,代工厂能力正在向OSAT和基板制造商延伸,以获得测试和组装能力,即使在供应链终端出现良率问题时,也能保护自身利益。
在过去几十年,原始设备制造商、电子制造服务厂商、晶圆代工厂、整合器件制造商和无晶圆厂都严重依赖于OSAT来领导或者联合领导先进封装技术的开发及升级。基于对SiP供应链的整体分析,Yole认为OSAT和代工厂业务模式的演变将成为有利趋势,从战略上保障了更多SiP业务。领先的OSAT可以通过良好的资本支出投资和并购,弥补缺少基板制造商和EMS能力的短板,从而实现完整的解决方案,以较低成本和协同设计的便利性来吸引无晶圆厂。同时,代工厂将管理与SiP相关的并购和资本支出,最大化平衡SiP的质量和性能。
这份报告详细分析了不同的先进封装平台供应链、SiP商业模式演变、相关厂商的战略,商业化趋势等等。

SiP供应链:商业模式演变
倒装芯片和引线键合占主导地位,但扇出封装和嵌入式芯片封装机会充足
SiP具有多项优势:封装尺寸更小、性能更佳、集成电磁干扰屏蔽功能;和独立封装或SoC封装相比,设计更灵活、成本更低。
目前,倒装芯片和引线键合技术在高端和低端SiP应用、2D/2.5D/3D异构SiP中得到了广泛应用。5G和连接性对尺寸、性能要求驱动低端SiP的发展,高端SiP则需要降低成本。随着最近对先进大尺寸封装需求的激增,制造商已经为倒装芯片/引线键合SiP(FC & WB SiP)量身定制了一轮新投资浪潮。此外,OSAT的独特性使其顺利完成了重新定位,从而具备了为FC & WB SiP生态系统提供完整解决方案的能力。
倒装芯片和引线键合SiP市场价值122亿美元(占SiP封装收入的90%以上),预计到2025年将达到171亿美元,2019-2025年复合年增长率为6%。倒装芯片和引线键合SiP率先为低端和高端应用创造价值,并在供应链中创造新的机遇。
扇出(FO)封装已经成为SiP的主要封装选项之一。然而,扇出封装在SiP的应用仍然受限于多芯片工艺的良率成本问题。因此,目前正在开发和采用FO SiP技术的厂商已经具有很强的专业知识和成熟的量产能力。该市场自2017年以来一直由台积电主导,2019年台积电在FO SiP的市场份额超过90%。FO SiP的关键应用仍然是移动和消费类电子。然而,随着数据中心、5G和自动驾驶的兴起,将推动FO SiP在电信、基础设施和汽车等方面的应用。
嵌入式芯片技术正从单芯片嵌入过渡至多芯片嵌入。IC基板和电路板的复杂性增强、尺寸变大,因为平均销售价格(对于特定市场的某些应用来说)将有所增长。在2019-2025年期间,嵌入式芯片SiP的出货量增长率将达27%左右,2025年其市场规模将超过3.15亿美元,主要来源于汽车、电信&基础设施、移动应用。尽管嵌入式芯片SiP市场规模很小,但是增长势头强劲。
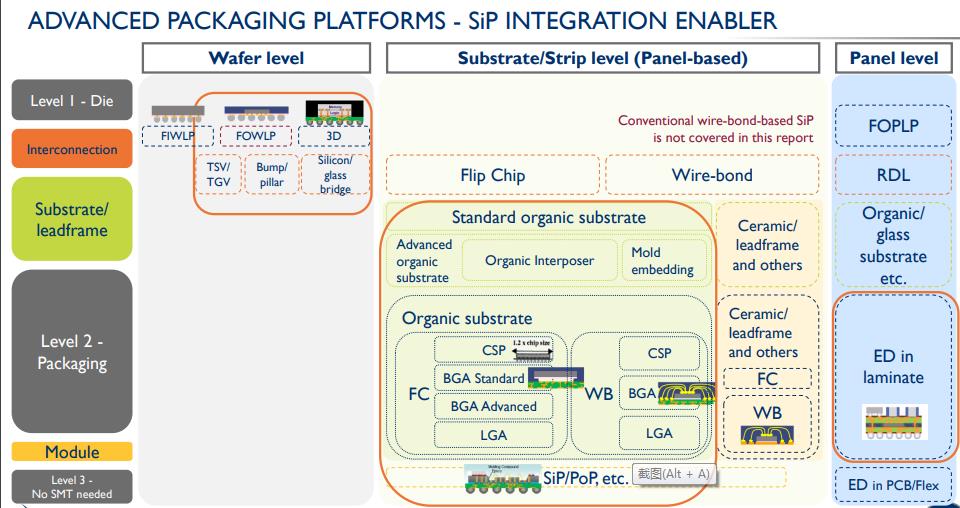
先进封装平台——SiP集成赋能者
本报告针对不同封装平台,覆盖各类应用,聚焦SiP技术趋势、发展路线图、市场驱动因素、技术挑战以及市场现状等。
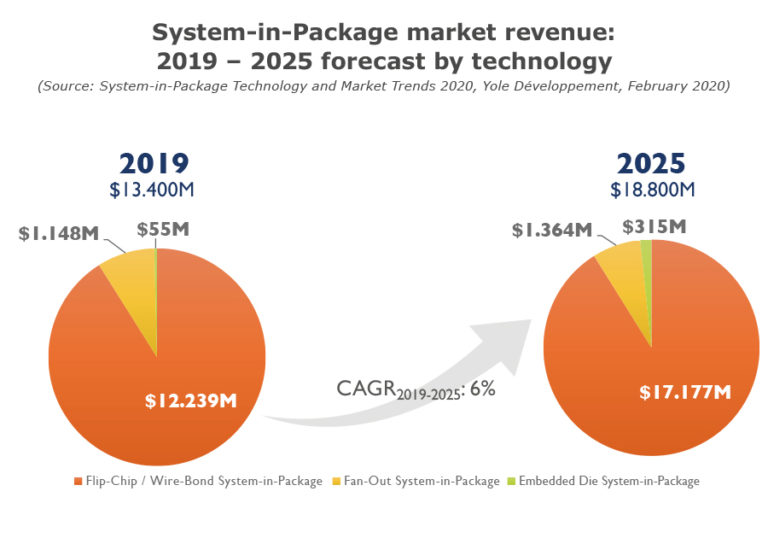
2019-2025年SiP市场规模(技术细分)
在各类应用对异质集成的需求驱动下,2025年SiP业务规模将突破190亿美元。
5G、连接性、网络、服务器和物联网等大趋势对SiP的需求越来越多,制造商的业务模式不断更新,SoC先进硅技术节点对成本的关注日益增加,封装技术的飞跃发展等一些列因素都将推动SiP市场的增长。
2019年SiP市场实现了134亿美元的营收,复合年增长率达6%,2025年市场规模将实现188亿美元。移动和消费类电子是SiP的最大市场(复合年增长率5%),紧随其后的是电信和基础设施(复合年增长率11%)和汽车市场(复合年增长率11%)。这些数据并不令人惊讶,作为新兴封装技术的先驱者,对上述市场而言,减少封装尺寸和提高性能是关键参数。
在移动和消费电子领域,手机占SiP 2019年市场最大份额。不过,增长最快的动力来自市场规模较小的其他终端设备。未来五年,未来5年,可穿戴设备、Wi-Fi路由器和物联网将在SiP市场快速增长,主要驱动因素是5G和传感器。尽管手机(尤其是智能手机)市场已经饱和,随着步入5G时代,为SiP创造了新的机会。在电信和基础设施领域,基站和服务器的复合年增长率都有望达到两位数,其中基站的年复合增长率高达41%。这主要是因为5G基站需要通过倒装芯片球栅阵列实现更多SiP集成。此外,服务器如CPU、 xPU(小芯片、硅转接板、扇出型)和现场可编程门阵列需要高端SiP。
在汽车和运输行业,高级驾驶辅助系统和资讯娱乐是主要驱动力。尽管摄像头的市场份额很小,但是ADAS的单目、双目和三目摄像头都将采用SiP,因此其增速最快。此外,视觉处理单元和资讯娱乐对计算能力也有要求。SiP的另一驱动力来自于MEMS和传感器,包括压力传感器、惯性测量单元、光学MEMS、微测辐射热计、振荡器和环境传感器等。医疗、工业、国防和航空航天等领域的SiP市场规模尚小,但在机器人和物联网相关应用中,其增速强劲。
本报告针对不同封装平台和不同应用,发布了2018年-2025年SiP市场预测,并对相关厂商及其市场份额进行分析。

2019年SiP市场份额

2019-2025年SiP市场规模预测(应用细分)
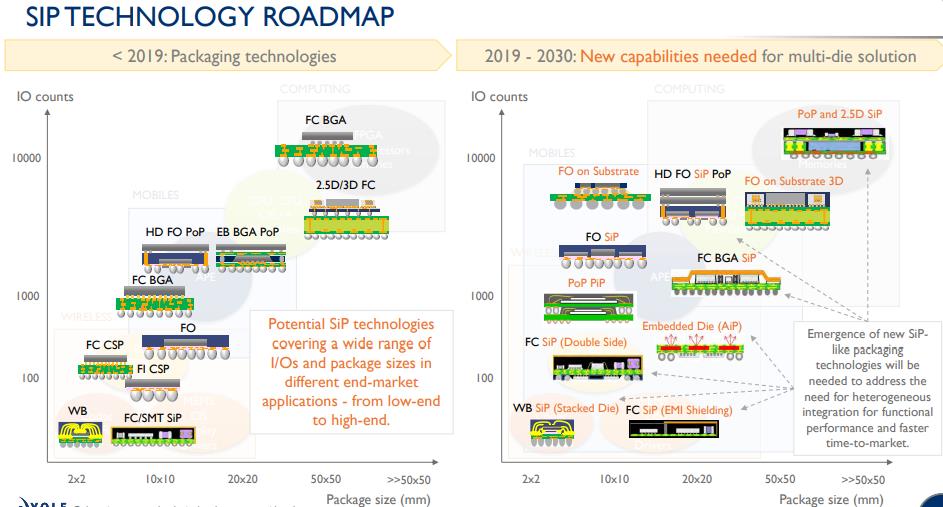
SiP技术路线图
关于《System-in-Package Technology and Market Trends 2020》
本报告共计330页,探索了先进封装领域的最热趋势,包括SiP市场预测(主要关注FC,WB,FO和ED)和市场发展趋势、市场份额以及整体产业链分析。
报告涉及的企业
Access, Amkor, Analog Devices, Apple, ARM, ASE, Avago, AT&S, Bosch, Broadcom, Carsem, China WLCSP, Chipbond, ChipMOS, Cisco, Continental, Cyntec, Cypress Semiconductor, Deca Technologies, Dyconex, Facebook, Fitbit, Flexceed, Flip Chip International, Formosa, Fraunhofer IZM, Freescale, Fujikura, Fujitsu, GaN Systems, General Electric, GlobalFoundries, Google, Hana Micron, Hella, Huawei, IMEC, Inari Berhad, Infineon, Intel, J-Devices, JCET, King Yuan, Lenovo, Linear Technology, LB Semicon, MediaTek, Medtronic, Meiko, Microchip, Microsemi, Nanium, Nepes, Nvidia, NXP, Nokia, ON Semiconductor, Orient Semiconductor, Powertech Technology Inc, Renesas, QDOS, Qorvo, Qualcomm, Rohm, Sarda Technologies, Samsung Electronics, SCC, Schweizer, SEMCO, SIMMTECH, SK Hynix, Shinko, ShunSin, SiPlus, Softbank, SONY, SPIL, Spreadtrum, STMicroelectronics, STATS ChipPAC, STS Semiconductor, Taiyo Yuden, TDK, Teraprobe, Texas Instruments, Tianshui Huatian, Tongfu Microelectronics, Tong Hsing, Toshiba, TSMC, Unimicron, Unisem, USI, UTAC, Wurth Electronics, and many more…
相关报告
《先进封装市场现状 (2019版)》
《扇出封装技术和市场现状(2019版)》
《手机应用的先进射频SiP封装(2019版)》
《先进封装市场季度报告》-新产品
《扇出封装工艺对比(2020版)》
购买方式
如需样刊或购买报告,请联系华进战略部:0510-66679351 Xiaoyunzhang@ncap-cn.com
以上图文译自Yole Développement的(x)PU: High-End CPU and GPU for Datacenter Applications 2020
原文请参考:https://www.i-micronews.com/products/xpu-high-end-cpu-and-gpu-for-datacenter-applications-2020/

关于华进
华进半导体于2012年9月在无锡新区正式注册成立,开展系统级封装/集成先导技术研究,研发2.5D/3D TSV互连及集成关键技术(包括TSV制造、凸点制造、TSV背露、芯片堆叠等),为产业界提供系统解决方案;同时开展多种晶圆级高密度封装工艺与SiP产品应用的研发,以及与封装技术相关的材料和设备的验证与研发。
微信:NCAP-CN



 中文
中文
 English
English 苏公网安备 32021402001899号
苏公网安备 32021402001899号