先进封装:OSAT、代工厂和IDM,都想入局
内容概览:
2019年,先进封装市场规模为380亿美元,且预期在2019年至2025年间将以6.6%的CAGR增长。
由于摩尔定律减缓和异质整合带来的强劲动力,加上5G、AI、HPC、IoT等大趋势,先进封装市场在整个半导体市场中所占的份额正在不断增加。截至2025年,它将占据总市场的近50%。
技术态势:先进封装正在从封装基板平台转向硅平台。这一趋势正为台积电、英特尔和三星带来巨大的机遇。
竞争局势:台积电在先进封装方面的活动已成为一项独立成熟的业务。2019年台积电从先进封装所获的预期收益为28亿美元,在2019年OSAT排行榜上占据第4位。
新冠疫情的影响:由于新冠疫情大流行,半导体业务在2020年将有所下降,但会在2021年恢复。先进封装市场在2020年将缩减7%,而传统封装市场则将缩减15%。
半导体供应链的参与者正在大力推进先进封装业务
半导体制造供应链中的封装领域曾是OSAT和IDM的传统专属,而今却发生着范式转变。来自包括代工厂、基板/PCB供应商、EMS/ODM在内的不同商业模式的竞争厂商们正在进入这一市场,并且在瓜分着OSAT的市场份额。毫无疑问,当前先进封装正从封装基板平台转向硅平台,这一重大转变为台积电、英特尔和三星这样的巨头带来巨大的机遇。这些领先厂商们在先进封装市场上展示实力,并脱颖而出,成为先进封装新技术的关键创新者。
《先进封装产业现状(2020年版)》已正式发布。该报告追踪产业演化路径,帮助业界理解市场和领先先进封装企业的关键战略,并且更新预测半导体和先进封装市场数据,同时分析了新冠疫情对所有市场数据的影响。该报告还谈及了中美贸易战,以及在半导体业务与供应链中的相关变化。2020年版的报告对排名前25家OSAT进行了财务分析,结合了不同参数分析每家领先厂商的市场定位和战略,包括营收、YoY增长、研发、资本性支出、毛利润、毛利率、净收入等。

华进半导体作为YOLE中国区代理,可为业界提供由Yole出版的先进封装系列报告和专业的市场监测季报。华进半导体携手合作伙伴YOLE还将于9月15日在中国无锡举行先进封装会议——2020 SYNAPS & 第七届华进开放日。作为一年一度的先进封装专业研讨会,每次都有超过140家企业参会。今年,我们将乘风破浪,邀请业界知名企业,为大家呈现更具吸引力的演讲。这些企业包括Besi、Camtek、长电科技、Evatec、海思半导体、华天科技、康宁、SPTS Technologies、武汉新芯、厦门云天半导体等。会议的战略性议题包括玻璃基板、扇出型封装、高性能应用……为期一天的活动将结合现场演讲和网络播放的形式,让全球先进封装产业链都参与其中。精彩活动,不容错过,现在就注册吧!
先进封装市场发展强劲
半导体产业的现状如何?先进封装产业从去年至今有什么演变?当前的关键市场驱动因素是哪些?有哪些先进封装厂商值得关注,他们正致力于什么创新平台?经过了新冠疫情,在经济和技术上有哪些挑战?顶级OSAT的排名如何:佼佼者都是谁?《先进封装产业现状(2019年版)》将为您全面解答。
在这个竞争激烈的领域,台积电的领先地位已经尤其突显,该公司开发了创新的先进封装平台,包含了扇出型封装(InFO)、2.5D硅中介层CoWoS和3D SoIC各项技术。就当前封装收益排名来看,台积电在OSAT中排名第4。
同时,其他诸如ASE/SPIL(日月光/矽品精密工业)、安靠科技(Amkor)和长电科技等顶级OSAT都在对先进SiP和扇出技术进行投资,以增强自身竞争力,提高先进封装市场份额。IC基板与PCB制造商、EMS公司和显示器产业的厂商凭借扇出型面板级封装、SiP和有机基板中的嵌入式芯片(以及无源器件),也在进军先进封装市场。这一趋势在2020年及以后都将持续。

2019年市场营收TOP 25 OSAT
2019年,IC封装市值680亿美元。 其中先进封装占了290亿美元,而且从2019年到2025年之间预期将以6.6%的CAGR增长,到2025年市值可达420亿美元。与此同时,传统封装市场将以1.9%的CAGR增长。而整个封装市场将以4%的CAGR增长,市值将从430亿美元增至850亿美元。先进封装市场在2014年到2015年的CAGR为6.1%,将从2014年的200亿美元增长至2025年的420亿美元左右,这几乎是传统封装市场在此期间预期增长的三倍。传统封装市场在这段同一期间内的CAGR预期为2.2%。
由于新冠疫情的影响,先进封装市场2020年的YoY预期将降低6.8%。但Yole认为该市场应该会在2021年反弹,YoY增长约为14%。随着高产量产品进一步渗透市场(例如:移动、网络和汽车领域中的扇出型技术;AI/ML、HPC、数据中心、CIS和3D NAND领域中的3D堆叠;以及汽车、移动和基站中的ED技术),CAGR最高的营收预期将来自于2.5D / 3D TSV IC、层压基板中的ED和扇出型(CAGR分别为21.3%、18%和16%)。在营收方面,移动与消费细分市场在2019年占据先进封装总营收的85%,且将以5.5%的CAGR增长,截至2025年将占先进封装营收的80%。电信与基础设施是营收增长最快的细分市场,从2019年至2025年之间的增长速度为13%。Yole预计该市场占总营收的比例将从2019年的10%增至2025年的14%。如果不包括汽车和运输细分市场,这项分析就不能算完整。在营收方面,该细分市场在2019年-2025年期间的CAGR为10.6%,市场规模将在2025年近19亿美元。

3D/2.5D堆叠和扇出已成为增长最快的先进封装平台
先进封装已经成为半导体创新的关键,并且对于弥补芯片和PCB之间的尺寸差距至关重要。先进封装可以通过增加功能和保持/提高性能来提高半导体产品的价值,同时降低成本。在各种先进封装技术中,FC占2019年市场营收的83%,但2025年其份额将下降到77%。而3D堆叠和扇出2019年的市场份额都为5%,2025年有望增长至10%和7%。3D堆叠和扇出将继续以21%和16%的惊人速度增长,进一步向各应用领域渗透。3D堆叠市场的增长主要由3D内存(HBM和3D DDR DRAM)、基于2.5D介质层的裸片分区和异质集成、3D SoC、Foveros、3D NAND和堆叠CIS等主导。随着不同商业模式的玩家进入该市场,扇出封装也将呈现强劲增长,在2019-2025年期间的CAGR为3.2%,主要由移动设备、Fan-in WLP主导。尽管嵌入式芯片的市场规模较小,但在未来五年,由于电信和基础设施、汽车和移动等市场的需求,CAGR有望达到18%。
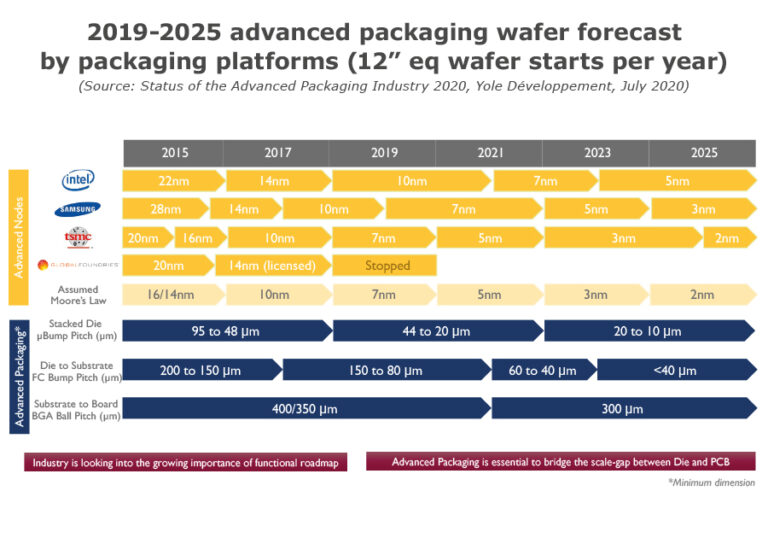
《先进封装产业现状(2020年版)》和《先进封装季度市场监测》这两份报告都对先进封装领域进行了深入探究。同时,如果想获得最新市场动态和技术发展的全面年度纵览,2020 SYNAPS & 第七届华进开放日绝对不容错过。
关于 Status of the Advanced Packaging Industry 2020
该报告追踪产业演化路径,帮助业界理解市场和领先先进封装企业的关键战略,并且更新预测半导体和先进封装市场数据,同时分析了新冠疫情对所有市场数据的影响。该报告还谈及了中美贸易战,以及在半导体业务与供应链中的相关变化。2020年版的报告对排名前25家OSAT进行了财务分析,结合了不同参数分析每家领先厂商的市场定位和战略,包括营收、YoY增长、研发、资本性支出、毛利润、毛利率、净收入等。
报告涉及的企业
Amkor, Analog Devices, Ardentec, Atmel, AOI Electronics, Apple, ARM, ASE, Avago, Bitmain, Broadcom, Carsem, China WLCSP, Chipbond, ChipMOS, Cisco, Cypress Semiconductor, Deca Technologies, Greatek, IC Interconnect, Fairchild, Facebook, Flip Chip International, Formosa, Freescale, Fujitsu, GlobalFoundries, Google, Hana Micron, Huawei, Inari Berhad, Intel, Intersil, J-Devices, JCET, King Yuan, Linear Technology, LB Semicon, Lingsen Precision, Maxim, MaxLinear, MediaTek, Microchip, Micron, Microsemi, Movidius, Nantong-Fujitsu, Nanium, Nepes, Nvidia, NXP, ON Semiconductor, OptoPAC and more…
相关报告
Advanced Packaging Quarterly Market Monitor, Q1, 2020,
Fan-Out Packaging Processes Comparison 2020
Equipment and Materials for Fan-Out Packaging
购买方式
如需样刊或购买报告,请联系华进战略部:0510-66679351 Xiaoyunzhang@ncap-cn.com
以上图文译自Yole Développement的Status of the Advanced Packaging Industry 2020,原文请参考:
https://www.i-micronews.com/products/status-of-the-advanced-packaging-industry-2020/

关于华进
华进半导体于2012年9月在无锡新区正式注册成立,开展系统级封装/集成先导技术研究,研发2.5D/3D TSV互连及集成关键技术(包括TSV制造、凸点制造、TSV背露、芯片堆叠等),为产业界提供系统解决方案。同时将开展多种晶圆级高密度封装工艺(包括WLCSP/Fan-out)与SiP产品应用的研发与大规模量产,以及与封装技术相关的材料和设备的验证与研发。
网址:www.ncap-cn.com
微信:NCAP-CN
业务联系:minghaozhou@ncap-cn.com

*转载须知*
文首注明:转载自华进半导体(ID:NCAP-CN)
阅读原文处,请插入华进半导体原文链接
未经同意,不可修改文章内容
若未遵守上述规则,将按侵权处理


 中文
中文
 English
English 苏公网安备 32021402001899号
苏公网安备 32021402001899号